BGA返修台使用方法与技巧
1、拆焊。1、返修的准备工作:针对要返修的BGA芯片,确定使用的风嘴吸嘴。‚根据磴涡湿蟾客户使用 的有铅和无铅的焊接确定返修的温度高低,因为有铅锡球熔点一般情况下在183℃,而绣诅收蟮无铅锡球的熔点一般情况下在217℃左右。ƒ把PCB主板固定在BGA 返修平台上,激光红点定位在BGA芯片的中心位置。把贴装头摇下来,确定贴装高度。2、设好拆焊温度,并储存起来,以便以后返修的时候,可以直接调用。一般情况下,拆焊和焊接的温度可以设为同一组。3、在触摸屏界面上切换到拆下模式,点击返修键,加热头会自动下来给BGA芯片加热。4、温度走完前五秒钟,机器会报警提示,发了滴滴滴的声音。待温度曲线走完,吸嘴会自动吸起BGA芯片,接着贴装头会吸着BGA上升到初始位置。操作者用料盒接BGA芯片即可。拆焊完成。
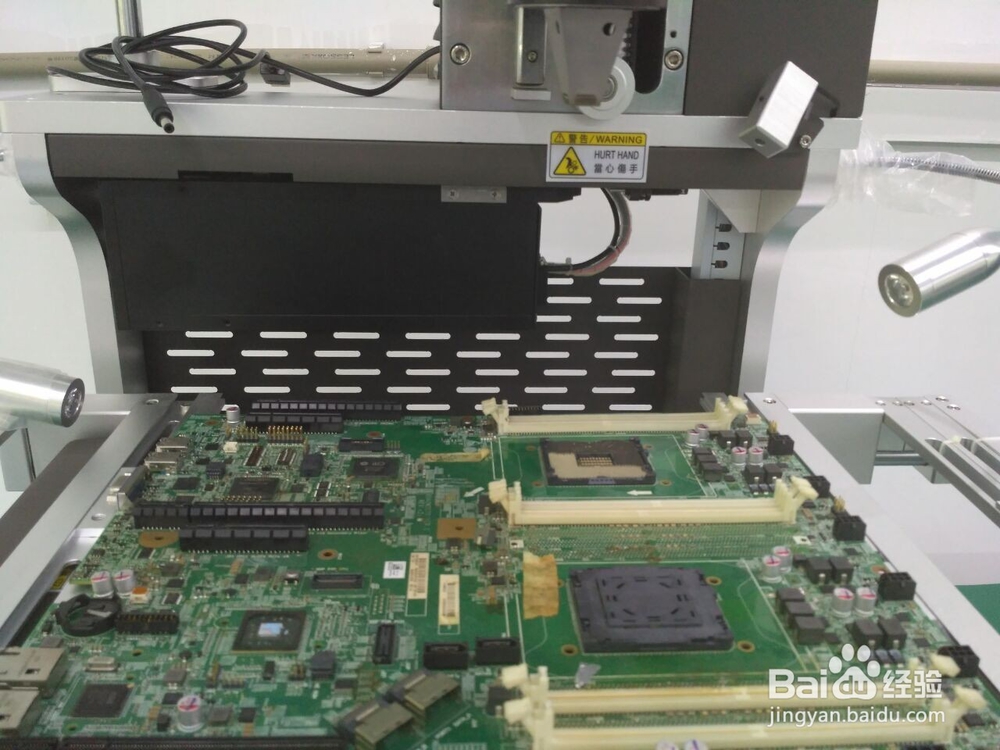
2、贴装焊接。1、焊盘上除锡完成后,使用新的BGA芯片,或者经过植球的BGA芯片。固定PCB主板。把即将焊接的BGA放置大概放置在焊盘的位置。2、切换到贴装模式,点击启动键,贴装头会向下移动,吸嘴自动吸起BGA芯片到初始位置。3、打开光学对位镜头,调节千分尺,X轴Y轴进行PCB板的前后左右调节,R角度调节BGA的角度。BGA上的锡球(蓝色)和焊盘上的焊点(黄色)均可在显示器上以不同颜色呈现出来。调节到锡球和焊点完全重合后,点击触摸屏上的“对位完成”键。贴装头会自动下降,把BGA放到焊盘上,自动关闭真空,然后嘴吸会自动上升2~3mm,然后进行加热。待温度曲线走完,加热头会自动上升至初始位置。焊接完成。
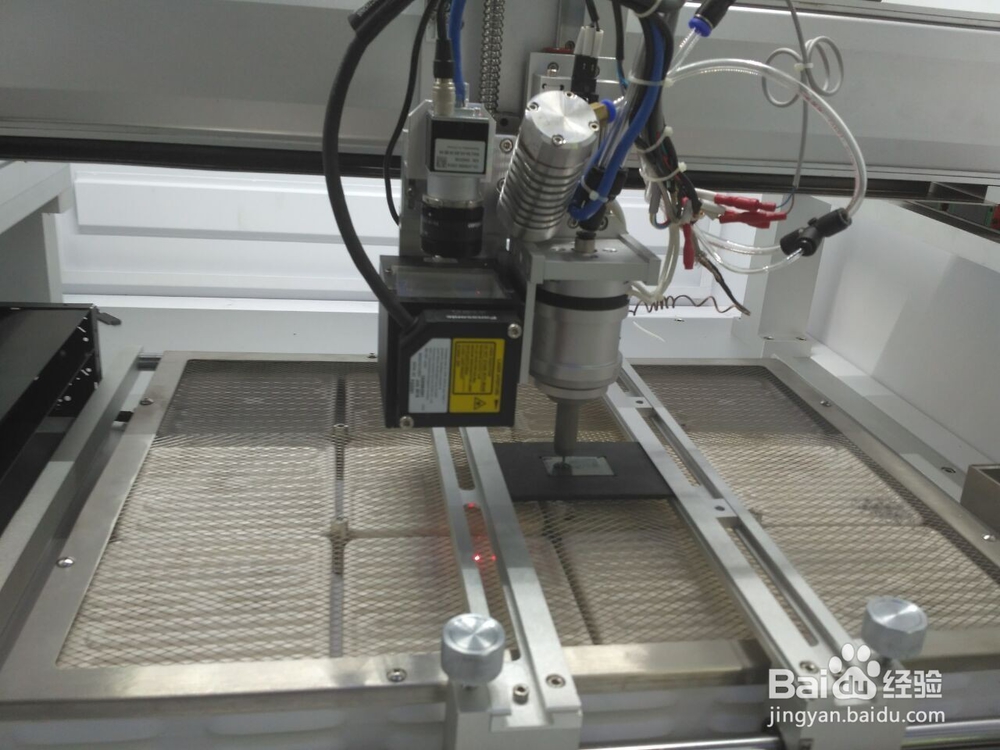
3、加焊。此功能是针对有一些前面因为温度低,而导致焊接不良的BGA,在此可以再进行加热。1、把PCB板固定在返修平台上,激光红点定位在BGA芯片的中心位置。2、调用温度,切换到焊接模式,点击启动,此时加热头会自动下降,接触到BGA芯片后,会自动上升2~3mm停止,然后进行加热。待温度曲线走完后,加热头会自动上升到初始位置。焊接完成
4、从整个结构上来说,所有的BGA返修台基本都大同小异。光学BGA返修台每个型号都具有各自的优势及特点,有兴趣的朋友可以去官网查询相关资料。